日本福田导电银粉
日本福田导电银粉
环氧树脂体系片状银粉
AgC-212(AgC-BW):微米级精密分散
电镜图及技术指标:
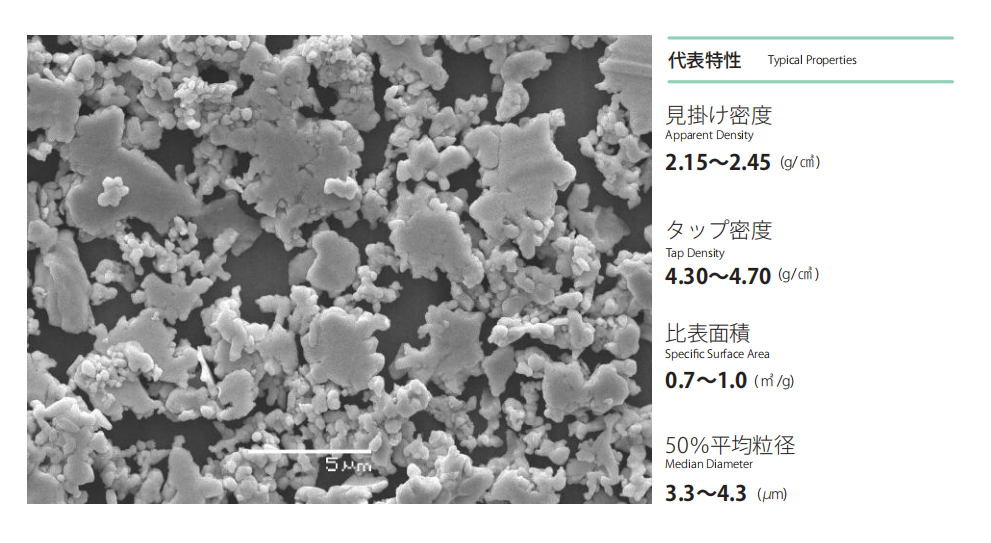
粒径分布:
中位粒径(D50)3.3~4.3μm,实测中位径3.786μm,众数粒径3.903μm,粒径分布标准差0.357,显示出高度均匀的颗粒分布特性。
性能优势:
微米级粒径与高比表面积:3~4 μm的粒径范围使其在环氧树脂中可实现微米级分散,极大增加银颗粒间的导电接触点,降低接触电阻。0.7~1.0 m2/g的比表面积平衡了界面结合力与分散效率,避免因表面能过高导致的团聚问题。
精准的球形度控制:通过福田独有的气流粉碎与表面包覆技术,颗粒呈现类球形结构,振实密度高达4.3~4.7 g/cm3,可在保持高填充量(体积分数 60%~70%)的同时维持浆料流动性,适合高导电需求的精密涂覆工艺。
低缺陷率:累积分布数据显示,25% 粒径(D25)为2.114 μm,75% 粒径(D75)为6.524 μm,颗粒粒径跨距(D75-D25)仅4.41 μm,有效减少因粒径差异导致的空洞或导电通路断裂问题。
主要应用:
固晶胶:用于 LED 芯片、功率器件与基板的粘接,要求银胶兼具高导电性(体积电阻率<10-4 Ω?cm)与抗跌落冲击性能。AgC-212的均匀粒径可形成致密导电网络,同时微米级颗粒对芯片表面的微纳结构具有更好的适应性,提升界面粘接强度。

芯片导电胶:在倒装芯片(Flip Chip)工艺中,银胶需通过毛细作用填充芯片与基板间隙。3~4 μm 的粒径既避免堵塞微米级间隙,又能通过紧密堆积形成连续导电通道,满足高频信号传输的低损耗需求。
AgC-2351:中粗粒径高填充
电镜图及技术指标:
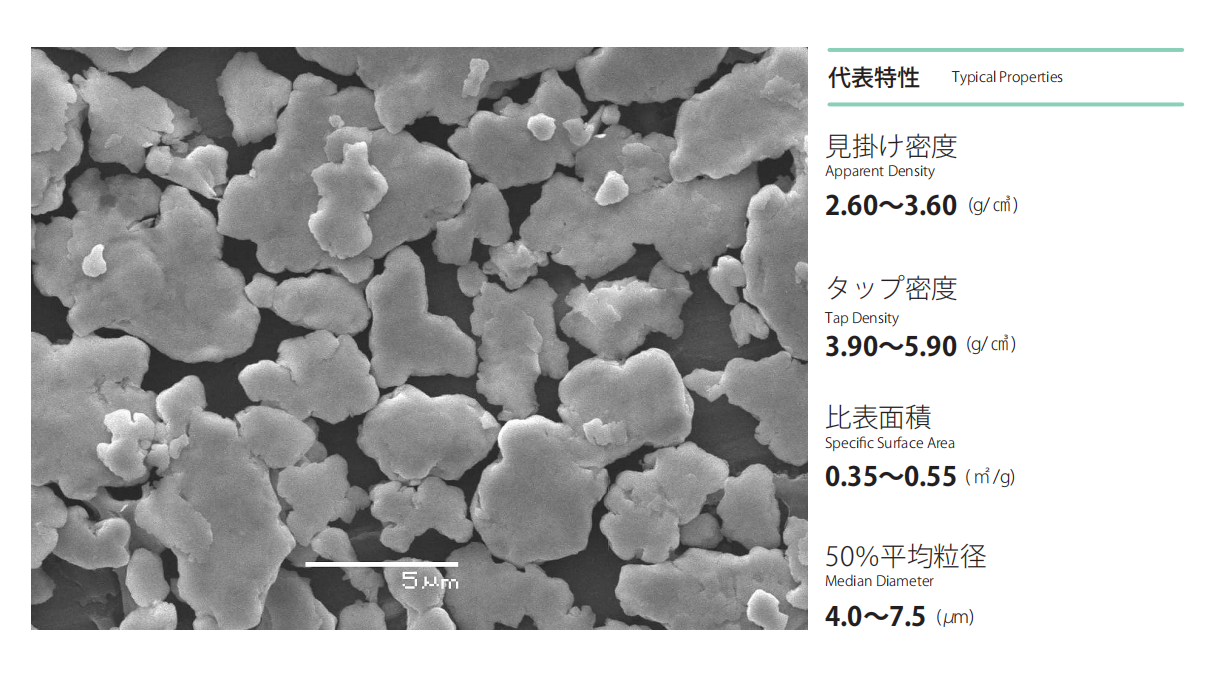
粒径分布:
中位粒径4.0~7.5 μm,实测中位径6.266 μm,众数粒径7.070 μm,标准差0.342,粒径分布略宽于AgC-212。
性能优势:
粗粒径与低比表面积:4~7.5 μm 的粒径范围与 0.35~0.55 m2/g 的比表面积,使其在高填充场景中表现优异。低比表面积减少树脂基体的吸附量,可实现更高的银粉体积分数(最高可达 80%),显著提升导热系数(>50 W/m?K)。
梯度填充效应:D25=3.575 μm 与 D75=9.536 μm 的宽粒径分布,形成 “细颗粒填充粗颗粒间隙”的梯度结构,既提高堆积密度,又降低浆料粘度,适合自动化点胶工艺。
抗沉降性:较大的颗粒重力与振实密度结合,可减少长期储存过程中的沉降分层,尤其适合需要长期货架期的单组份环氧胶体系。
主要应用:
晶振胶:在石英晶体振荡器封装中,银胶需承受高频振动下的力学负荷。粗粒径银粉的刚性支撑作用可减少胶体形变,避免因振动导致的电极断裂,同时低比表面积降低吸湿风险,提升器件长期可靠性。
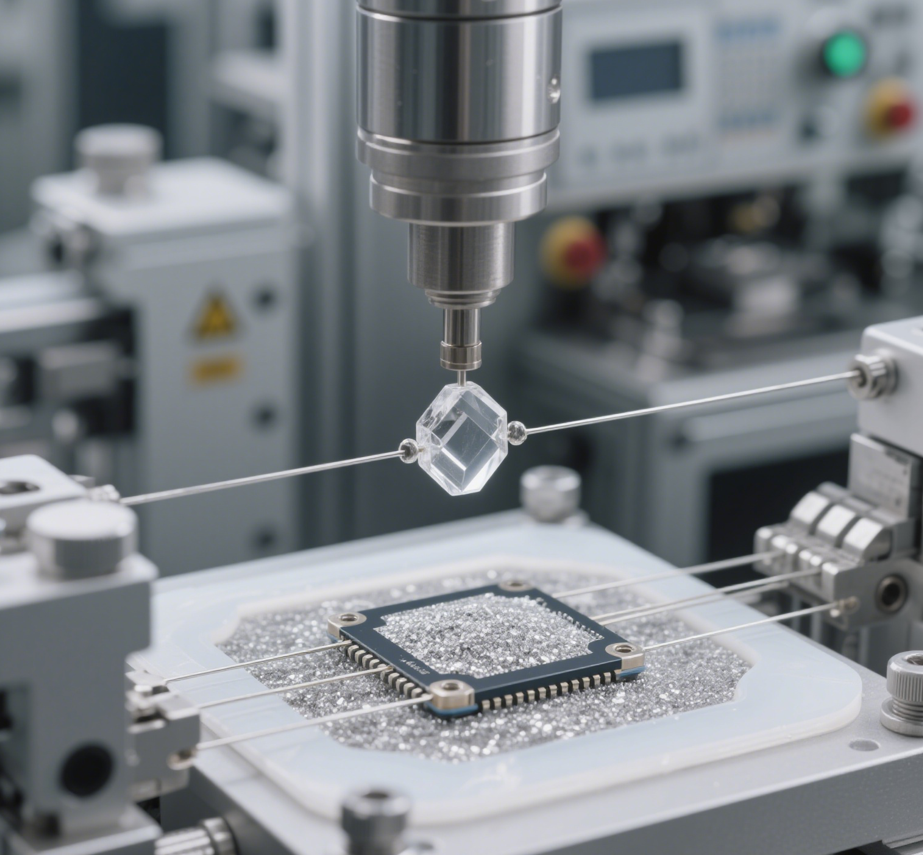
导电导热胶:用于功率模块、CPU散热器等需要同时传导电流与热量的场景。AgC-2351的高填充特性可构建银颗粒直接接触的导热通路,配合环氧树脂的绝缘性,实现电-热性能的平衡。
AgC-2190H:大粒径高稳定性
电镜图及技术指标:
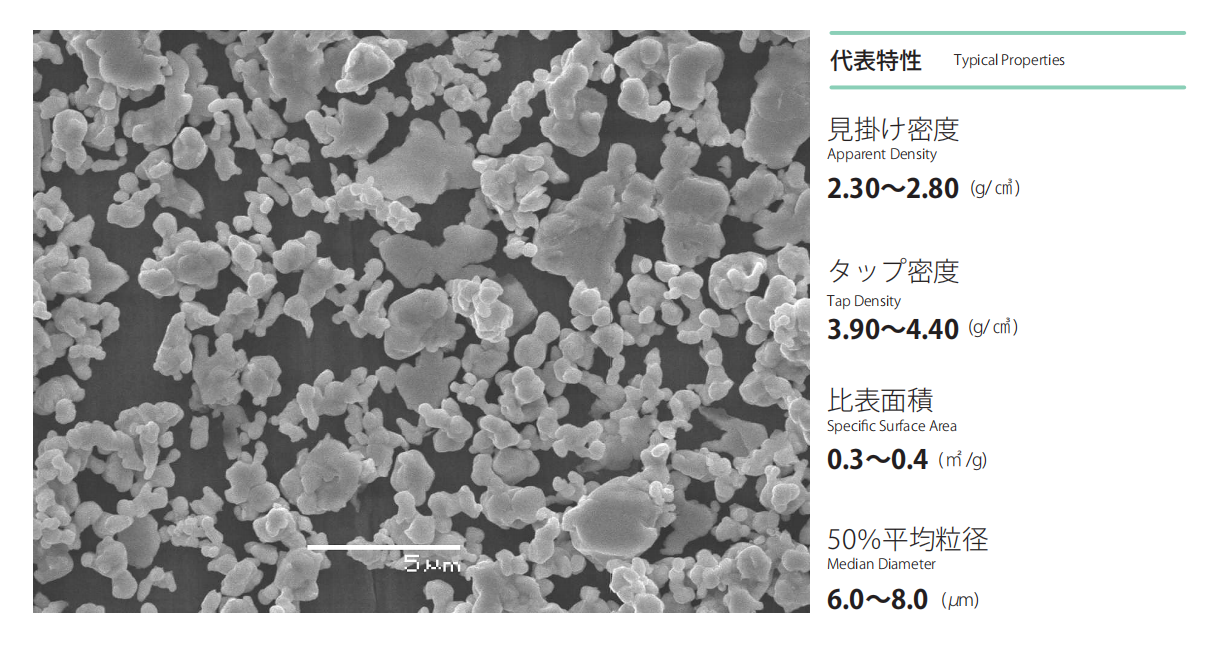
粒径分布:
中位粒径6.0~8.0 μm,实测中位径7.401 μm,众数粒径8.619 μm,标准差0.354,三款产品中粒径最大。
性能优势:
大粒径与低表面能:6~8 μm 的粒径使其在胶体中形成骨架结构,提升整体刚性,适用于需要抗蠕变或抗冲击的结构型粘接场景。0.3~0.4 m2/g 的比表面积进一步降低表面活性,减少与树脂的过度交联,避免胶体脆化。
低收缩率:大粒径颗粒的堆积空隙率较低,固化过程中树脂收缩对导电网络的破坏更小,适合大面积涂覆或厚层粘接(如传感器芯片与基底的粘接)。
工艺兼容性:适中的振实密度(3.9~4.4 g/cm3)使其在溶剂型与无溶剂型环氧体系中均能保持良好分散,可适配喷涂、刮涂等多种涂布工艺。
主要应用:
结构型导电胶:在汽车电子、工业传感器等需要承受机械应力的场景中,AgC-2190H 的大粒径骨架可增强胶体抗剪切强度,同时维持导电性能(体积电阻率<5×10-4 Ω?cm)。

高温可靠性场景:低比表面积减少高温下银颗粒的氧化速率(实测 150℃老化 1000 小时后电阻增幅<15%),适合发动机周边电子元件的封装。
有机硅树脂体系片状银粉
AgC-218K:无毒副反应性
电镜图及技术指标:

粒径分布:
50% 粒径 5.4 μm,实测 D25=2.894 μm,D75=8.744 μm,粒径跨距较大,呈现双峰分布特征。
性能优势:
有机硅界面适配性:针对有机硅树脂分子链柔性高、交联密度低的特点,AgC-218K 通过特殊硅烷偶联剂包覆处理,实现银颗粒与聚硅氧烷链段的化学锚固,解决传统银粉在有机硅中易沉降、界面结合弱的问题。
高柔韧性导电网络:5.4 μm 的中位粒径与较宽的粒径分布,使银颗粒在有机硅基体中形成柔性导电链,可承受20% 以上的拉伸形变而不破坏导电通路,适合可穿戴设备、柔性电路板等动态弯曲场景。
耐候性强化:比表面积 1.01 m2/g 略高于环氧树脂用产品,但通过表面抗氧化处理(如包覆超薄 SiO?层),在 UV 照射、湿热环境(85℃/85% RH)下电阻稳定性大幅提升,满足户外电子器件(如太阳能电池互连胶)的需求。
主要应用:
有机硅导电胶:用于 LED 模组灌封、天线射频元件粘接等,要求胶体兼具导电性与耐黄变性。AgC-218K 与有机硅树脂的化学相容性可避免迁移析银现象,长期保持透光率>90%。

高温密封胶:在 200℃以上环境中(如航空航天线束密封),有机硅基体的热稳定性与 AgC-218K 的抗烧结特性结合,可维持导电性能稳定,同时防止银颗粒因高温熔融导致的短路风险。
安特普纳公司提供日本福田金属箔粉的片状银粉产品,覆盖了从微米级精密导电到粗粒径导热增强的多种需求,还通过树脂体系定制化设计,为先进电子封装提供了 “材料-工艺-器件”协同优化的解决方案,推动电子产业向小型化、高频化、高可靠性方向迈进。